NVIDIAのAI GPUはTSMCのCoWoS先進パッケージングに依存しているが、この生産能力はTSMCの生産能力の拡大にもかかわらず逼迫した状況が続いている。NVIDIAはこれに対処するため、次世代Blackwell GB200 GPUにおいて、予定より早くパネル・レベル・ファンアウト・パッケージング(FOPLP)を使用する可能性があるようだ。
NVIDIAはAIチップ需要に応えるため設計の多様化を目指す
半導体の製造は長期間にわたるプロセスであり、まずIntelやTSMCのような製造業者がシリコンウェハーに回路を慎重に堆積および印刷し、厳格な清潔基準を遵守することが必要となる。チップが作成された後、それらはAIやその他のワークロードを処理できるように他のコンポーネントと共にパッケージングする必要がある。
チップパッケージングにはいくつかの方法がある。現在、業界標準のアプローチはウェハー・レベル・ファンアウト・パッケージング(FOWLP)である。このプロセスでは、ウェハーをチップに切断し、それらを再度組み立てて必要な回路を配置するためのスペースを追加したウェハーにするアプローチだ。
ファンアウト・パッケージングにより、チップメーカーはパッケージングプロセスから不良チップを除去することができる。
今回NVIDIAが導入を計画しているというパネル・レベル・ファンアウト・パッケージング(FOPLP)は、FOWLPを更に高度にした物だ。FOPLPのパッケージングの主な違いは、切断されたチップをウェハーに再度組み立てるのではなく、より大きなパネルに再度組み立てる点だ。これにより、メーカーははるかに多くのチップをパッケージングでき、パッケージングプロセスのコストを削減できる。また、パネルの端にあるチップもパッケージングできるため、パッケージングの効率も向上する。
NVIDIAはBlackwellチップに対して、このFOPLPを採用することを検討しているようだ。
経済日報によると、台湾の企業であるPowerTechやInnoluxがFOPLP技術を開発している。Innoluxの代表者は、FOPLPが今年の終わりまでに量産に入ることができると述べている。また、報告によると、NVIDIAのBlackwell製品に対するCoWoS(チップオンウェーハオンサブストレート)パッケージングの容量が厳しいため、Blackwell GB200が当初の2026年の予定よりも早く、2025年にFOPLPを使用し始める可能性があるという噂がある。
最後に、経済日報の情報筋によると、2025年には420,000個のGB200チップが納品される予定で、2025年には生産量が200万ユニットに拡大する見込みのようだ。
Sources
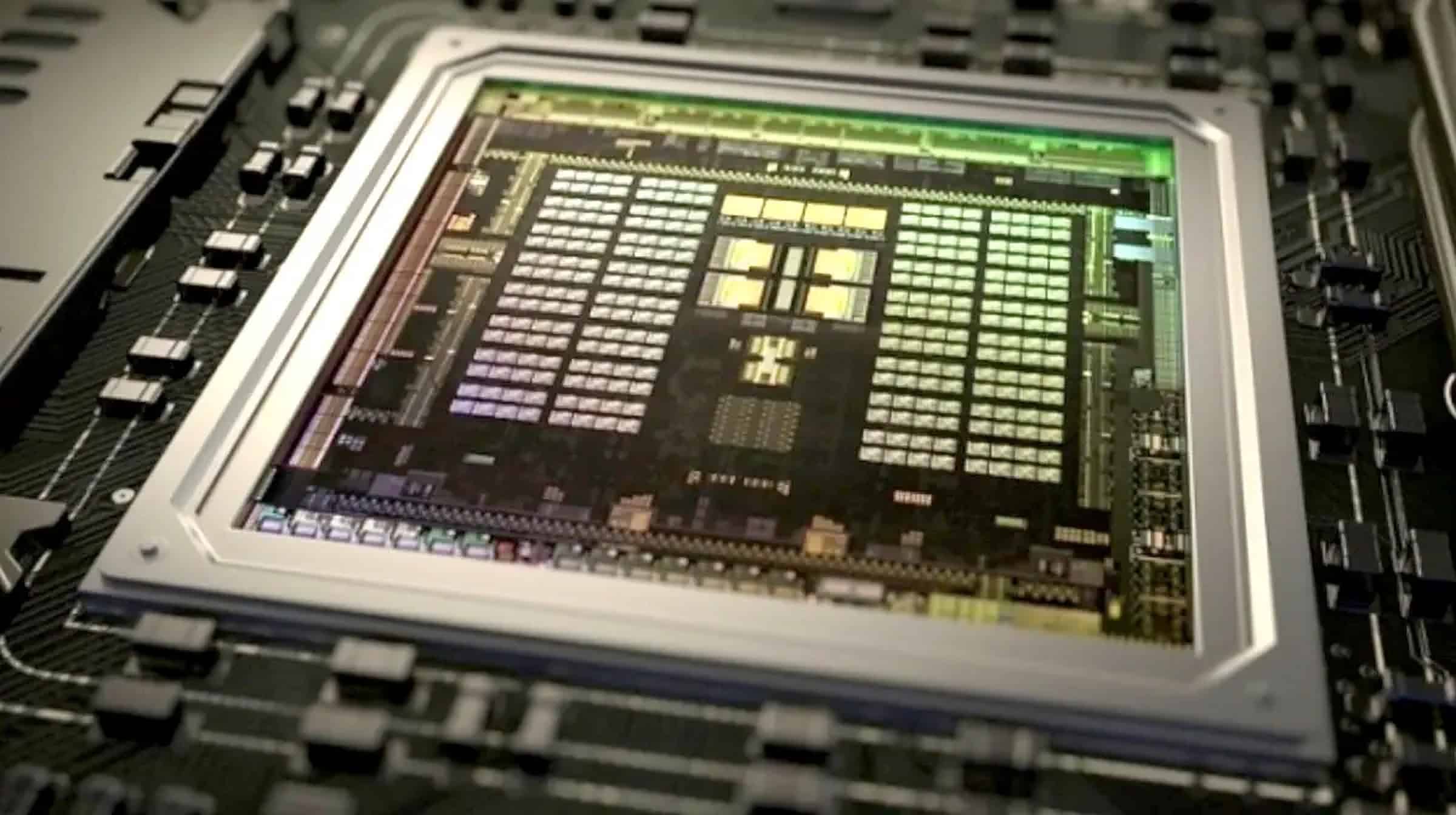


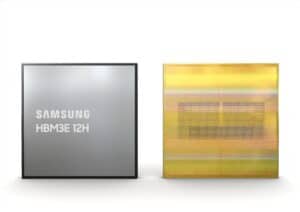




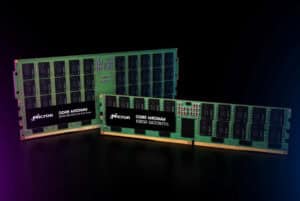

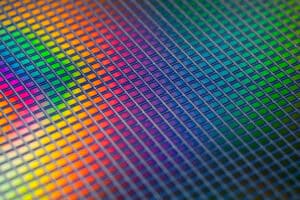
コメント