SamsungはAI特需に湧く業界の中で、HBM(高帯域幅メモリ)の供給では後れを取っているが、早くも次世代のHBM4での革新に目を向けており、そこでは革新的な3Dパッケージングテクノロジーを導入する計画のようだ。
3Dパッケージングテクノロジー開発競争も激化
Samsungの独自の3Dパッケージングテクノロジー「SAINT(Samsung Advanced Interconnect Technology)」は、これまでの2.5Dパッケージングテクノロジー「H-Cube」の後継となる物だ。
これまでの2.5Dパッケージングテクノロジーは、シリコンインターポーザを介して HBM チップと GPU を水平に接続していた。TSMCの有名な「CoWoS」もこれに当たるパッケージングテクノロジーだ。
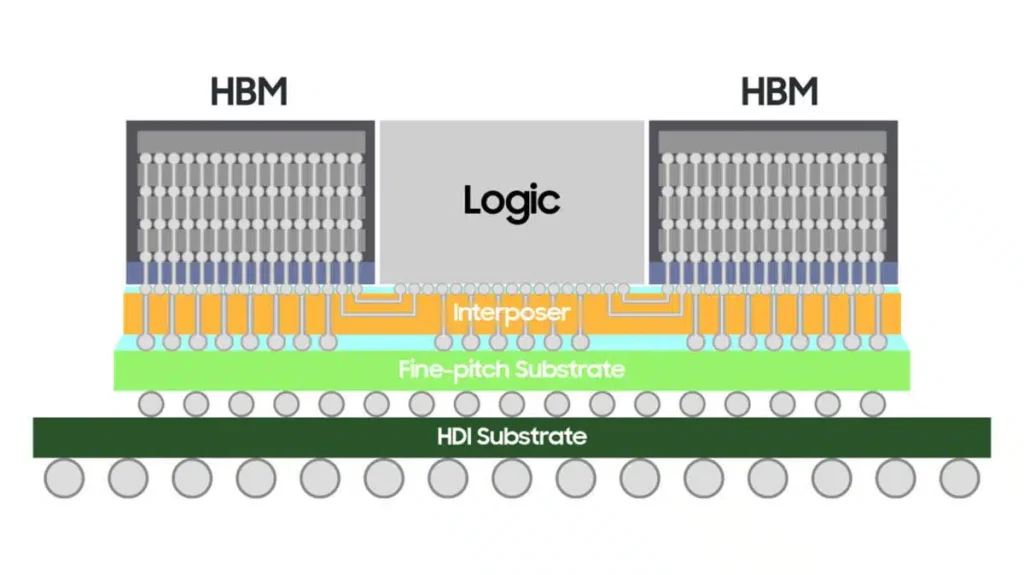
対して、3Dパッケージングテクノロジーはチップを垂直に積層しチップ間の通信にインターポーザーを介することを不要とする。これにより、データ転送の高速化、信号のクリーン化、消費電力の削減、レイテンシーの低減など、数々の大きなメリットがもたらされる。

SamsungはこのSAINTを長年開発していたが、昨年詳細が公開された。これには、SRAM用の「SAINT-S」、ロジック用の「SAINT-L」、そして、CPUやGPUなどのロジックチップの上にDRAMをスタッキングするための「SAINT-D」が含まれる。
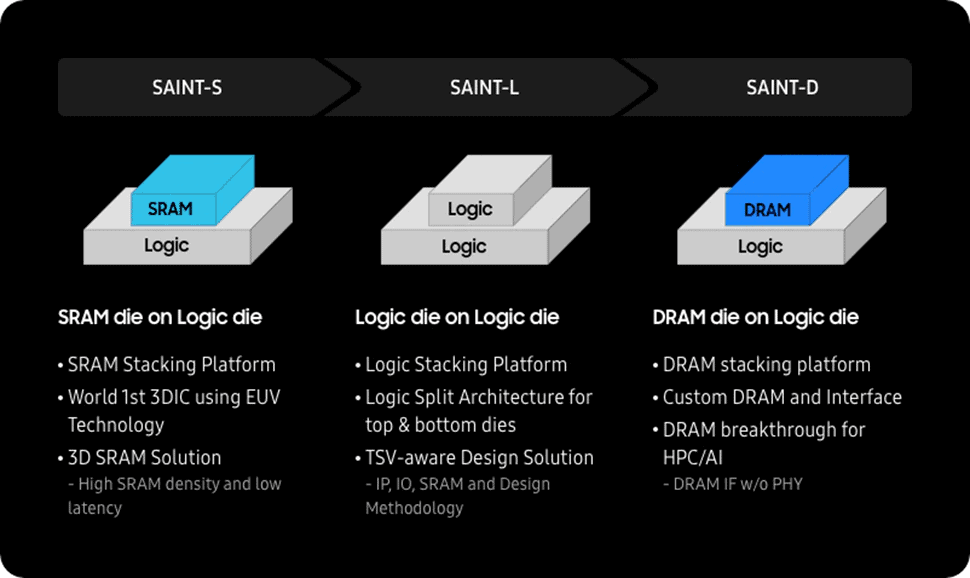
既にSAINT-Sについては検証テストが終了しており、今年中に導入が開始される予定ある事が以前伝えられていたが、今回同社はこの取り組みについて、Samsung Foundry Forum 2024にて改めて明らかにした形だ。
ただし、3Dパッケージング・ソリューションは高いコストがかかるため、Samsungは「ターンキー」サービスとして提供し、関心のある顧客に多くのHBMチップを販売したいと考えているようだ。
Korean Economic Dailyによると、このSAINTは2026年にも登場するNVIDIAの次世代アーキテクチャ「Rubin」にて、HBM4と共に採用される可能性が高いという。
Samsungはまた、2027年までに半導体のデータ伝送速度を飛躍的に向上させる光素子をAIアクセラレータの統一パッケージに組み込んだ「オールインワンヘテロジニアス統合」技術をリリースする予定だ。この技術は、インテグレーターが個別のパッケージング技術に対応することなく、単一の統合AIパッケージを可能にする。IntelはLunar Lake CPUのような薄型軽量設計のために非常にSOC中心のアプローチを採用しており、AMDもコンシューマーやクライアント向けに複数のチップにまたがる独自のHBM、MCD、3D V-Cacheスタックを搭載し、垂直スタッキングシーンに非常に積極的なようだ。

Source
- Korea Economic Daily: Samsung to launch 3D HBM chip packaging service in 2024





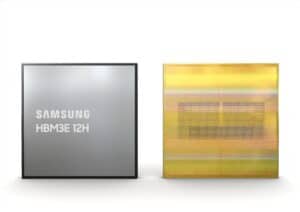





コメント