電気自動車大手のTeslaが自社の次世代スーパーコンピューター「Dojo 3」向けに、半導体製造はSamsung Foundry、パッケージングはIntel Foundryという前例のない「デュアルサプライヤー戦略」を採用することが明らかになった。従来のTSMC一社依存から脱却し、製造と後工程を分離するこの動きは、AI半導体サプライチェーンに新たな競争軸をもたらす可能性がある。背景には、技術的課題、供給制約、そして業界再編の思惑が交錯しているようだ。
TSMC依存からの脱却と、異例のSamsung–Intel協業
これまでTeslaは、Dojo 1・2世代の開発で台湾TSMCに前工程(チップ製造)から後工程(パッケージング)まで一括委託してきた。しかし、3世代目となるDojo 3では、前工程をSamsung、後工程の特殊パッケージングをIntelが担当する体制に移行する。
Samsungは米国テキサス州テイラーの新工場で、Teslaの次世代AI6およびDojo 3用カスタムD3チップを2nmプロセスで量産予定。これらはFSD(完全自動運転)、ヒューマノイドロボット、データセンター向けに単一アーキテクチャで設計され、用途に応じて数個から数百個のチップを組み合わせて使う構想だ。
一方、Intelは自社のEMIB(Embedded Multi-Die Interconnect Bridge)技術を活用してモジュールレベルのパッケージングを担当。EMIBは従来の2.5Dパッケージングのように大面積インターポーザーを使わず、小型シリコンブリッジで複数ダイを接続する方式で、柔軟なレイアウトと追加機能の統合が可能だ。
技術的背景:超大規模チップとパッケージングの課題
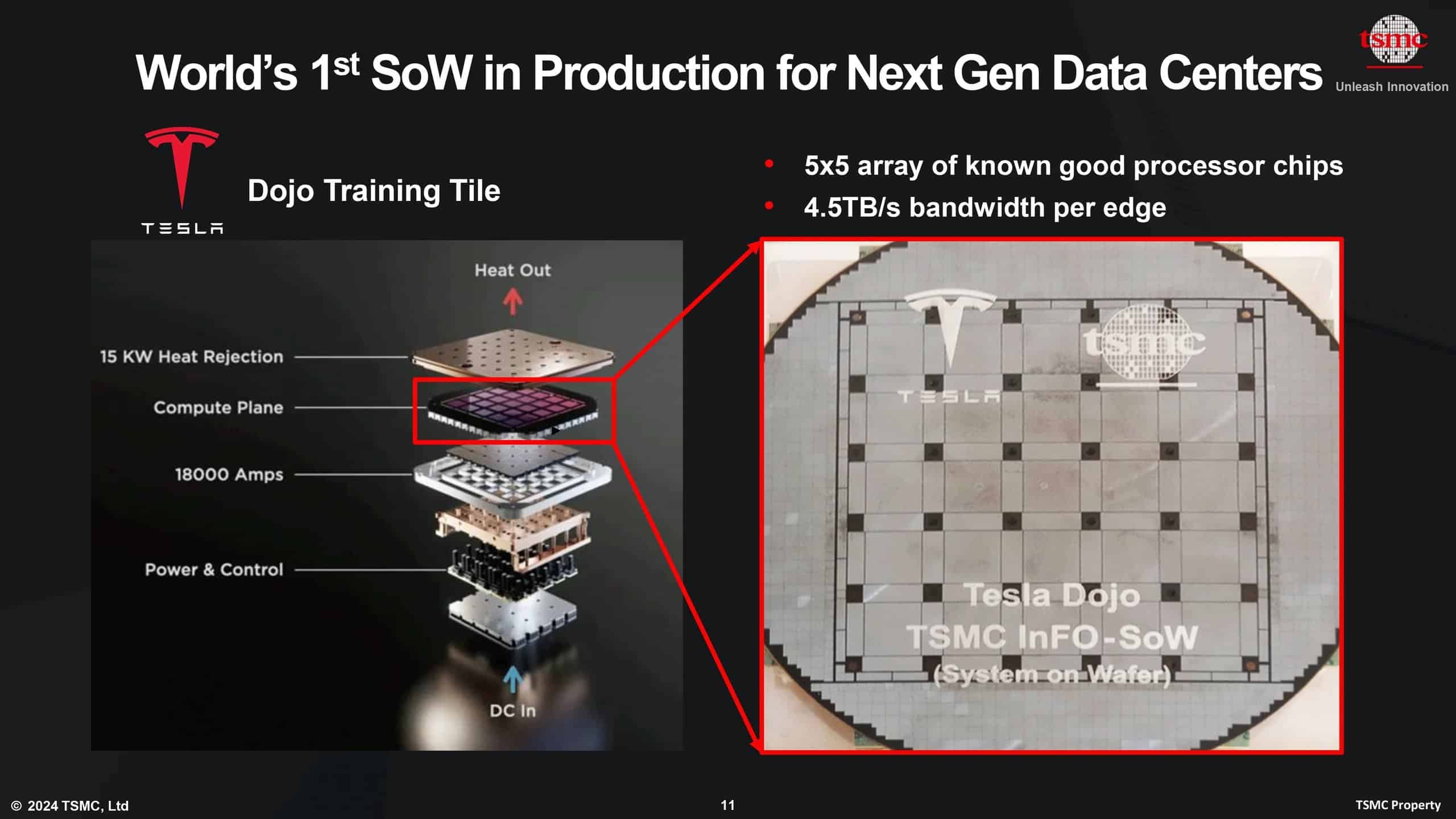
TeslaのDojoモジュールは、654mm²という巨大なダイを25個並べて電気的に接続する「トレーニングタイル」構造を持つ。従来TSMCはSoW(System-on-Wafer)技術でこれに対応してきたが、同社のCoWoS系パッケージングラインはAI需要の急増で逼迫。少量かつ特殊なTesla案件は後回しになりやすくなっていた。
EMIBはモジュール設計の自由度を高める一方、現状ではSoWのようなウェハー全体規模の巨大チップには制約がある。このため業界内では、IntelがDojo 3向けにEMIBの新バージョンや専用設備投資を検討しているとの見方も出ている。
Samsung側も大型チップ対応のパッケージング技術を高度化中で、将来的にはIntelに加わる形で後工程にも参入する可能性が指摘されている。
戦略的意義と業界への波紋
今回のデュアルサプライヤー戦略は、Teslaにとって以下のメリットがある。
- 供給リスクの分散:製造と後工程を別ベンダーに委託することで、一方の供給障害が全体に波及するリスクを軽減。
- 技術最適化:Samsungの先端2nmノードとIntelの柔軟なパッケージング技術を組み合わせ、歩留まり・性能・コストを最適化。
- 交渉力強化:TSMC一強構造への依存から脱却し、価格や納期での交渉力を確保。
業界的には、これまでライバル関係にあったSamsungとIntelが一つの顧客案件で協業する異例の構図が誕生する。AI需要の爆発的拡大と先端パッケージングの逼迫が、競合関係の再編を促している。
また、この動きは他のハイパースケーラーやAI半導体企業にも影響を与え、マルチベンダー戦略を採用する流れが加速する可能性がある。特にNVIDIAやAMDがAI向けパッケージング供給制約に直面している現状を考えると、Tesla方式は一つのモデルケースとなり得る。
FSDから汎用AIインフラへ
TeslaはDojo 3とAI6を中核に、FSD強化だけでなく、ヒューマノイドロボットやデータセンター事業にも踏み出そうとしている。巨大モジュールを効率的に製造・組み立てられるかが、スケールアウトの鍵だ。
短期的にはIntelのEMIB能力とSamsungの量産体制が試されるが、中長期的にはパッケージング技術の進化と、複数ベンダー間の協業モデルがどこまで定着するかが注目点となる。TSMCの対応や、他社による対抗戦略も見逃せない。
Sources
