生成AIの爆発的な進化が、半導体業界の勢力図に大きな変化をもたらしている。ムーアの法則の物理的限界が囁かれる中、チップの性能向上を牽引する主戦場は、微細化一辺倒だった「前工程」から、チップをいかに賢く、効率的に繋ぐかという「後工程」、すなわちアドバンストパッケージングへと急速にシフトしているのだ。この新たな戦場でゲームチェンジャーとなりうる革新的な製造装置を、光学技術の巨人ニコンが発表した。最大600×600mmの大型角型基板に対応するデジタル露光装置「DSP-100」である。これは、従来の円形ウェハーでは不可能だった圧倒的な生産効率を実現し、AI半導体の未来を左右する可能性を秘めている。
なぜ今、「丸いウェハー」が限界なのか? 面積効率の壁
半導体製造の象徴ともいえる、きらびやかな円形のシリコンウェハー。長年、この300mmウェハーが業界標準として君臨してきた。しかし、AIやハイパフォーマンスコンピューティング(HPC)向け半導体の進化が、その常識に揺さぶりをかけている。
現代の高性能プロセッサは、単一の巨大なチップではなく、機能ごとに分割された小さなチップ(チップレット)を高密度に接続する設計が主流だ。これらのチップレットを搭載する土台となるのが「インターポーザー」と呼ばれる中継基板だが、AIの要求性能を満たすためには、このインターポーザー自体が年々大型化している。
問題は、円形のウェハーから四角いチップやインターポーザーを切り出す際の「無駄」にある。特にパッケージサイズが大きくなるほど、ウェハーの縁の部分に生じる切り捨て領域(スクライブロス)が増大し、面積効率が著しく悪化する。ニコンが示す試算は衝撃的だ。例えば、100mm角の大型パッケージを製造する場合、直径300mmのウェハーからは、わずか4個しか取ることができない。 これでは、需要が爆発するAI半導体を、十分な量かつ低コストで供給することは困難である。
この根源的な課題を解決する切り札として期待されているのが、円形ウェハーの代わりに、巨大な正方形の基板(パネル)を用いる「パネルレベルパッケージング(PLP)」という技術なのである。
ニコンの回答「DSP-100」- その驚異的なポテンシャル
ニコンが2025年7月から受注を開始する「DSP-100」は、まさにこのPLP時代の到来を告げる戦略的製品だ。 その核心は、従来の常識を打ち破る圧倒的な基板サイズへの対応にある。
DSP-100の主な仕様:
- 対応基板サイズ: 最大600×600mmの角型基板
- 解像度: 1.0μm L/S (Line and Space)
- 重ね合わせ精度: ≦±0.3μm
- スループット: 1時間あたり50パネル (510×515mm基板の場合)
- 光源: i線相当 (水銀ランプの波長の一種)
最大の注目点は、その生産性だ。DSP-100が対応する600×600mmの角型基板を使えば、前述の100mm角パッケージを実に36個も一度に製造できる。 これは、従来の300mmウェハーと比較して、単純計算で9倍という驚異的な生産性向上を意味する。 これまでコストの足枷となっていた大型インターポーザーの量産に、道が拓けることになる。

「マスクレス」と「マルチレンズ」が拓く製造革命
DSP-100の革新性は、単に基板が大きいというだけではない。それを実現するために、ニコンが長年培ってきた2つの独自技術が融合されている。
一つは「マスクレス露光技術」である。 従来の露光装置は、回路パターンが焼き付けられた「フォトマスク」と呼ばれる原版に光を当て、レンズを通してパターンを転写していた。しかし、基板が大型化すると、巨大で高価なフォトマスクが必要となり、コストと製造リードタイムを圧迫する。DSP-100は、このフォトマスクを完全に不要にした。代わりに、SLM(空間光変調器)と呼ばれるデバイスにデジタルデータで回路パターンを表示し、そこに光源を照射して直接基板にパターンを投影する。 これにより、設計変更にも柔軟に対応でき、開発サイクルを大幅に短縮できるだけでなく、フォトマスクのサイズという物理的な制約からも解放される。
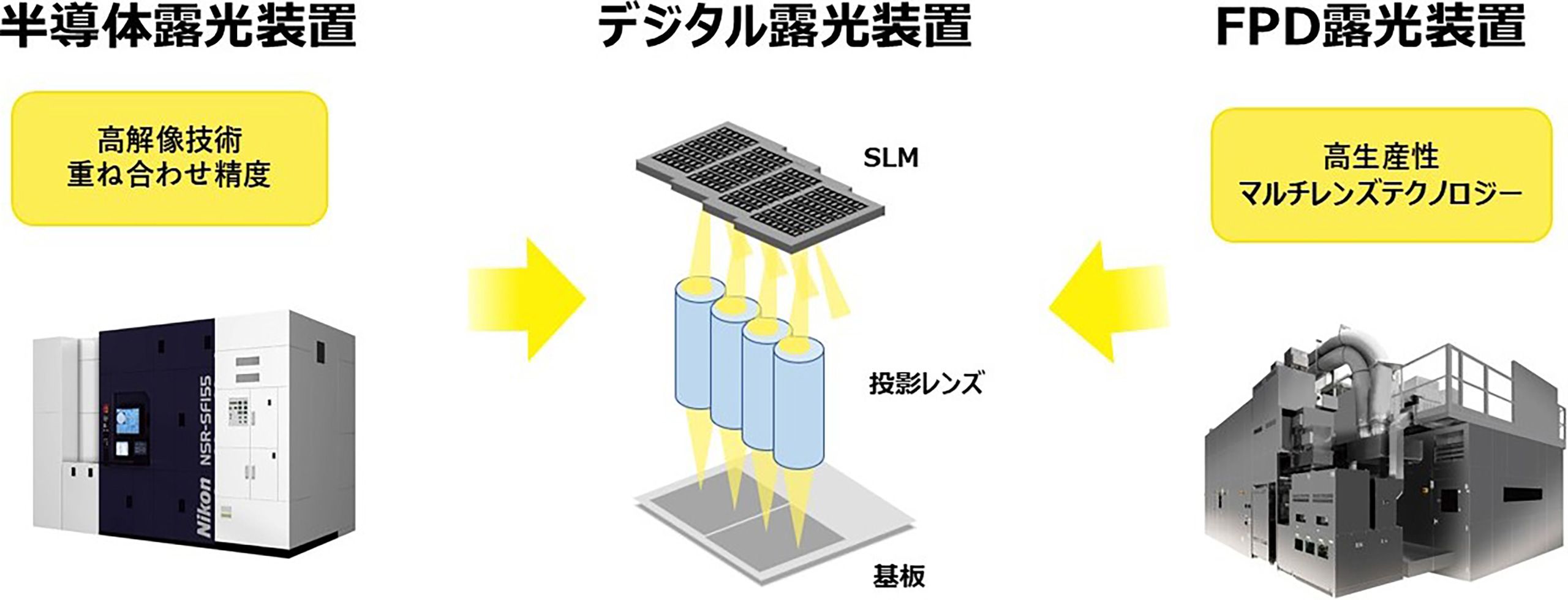
もう一つの核心が、ニコンがFPD(フラットパネルディスプレイ)露光装置で世界トップシェアを誇る原動力となった「マルチレンズテクノロジー」だ。 巨大な基板全体に歪みなく均一なパターンを焼き付けるには、巨大な単一投影レンズが必要となるが、これは技術的にもコスト的にも現実的ではない。そこでニコンは、複数の比較的小さな投影レンズを精密に制御し、つなぎ目なく(スティッチング)露光することで、あたかも一つの巨大なレンズで露光したかのような結果を得る技術を確立した。DSP-100は、このFPDで培った資産を半導体パッケージング分野に最適化して応用しているのである。
巨人たちの戦場とニコンの立ち位置
アドバンストパッケージング市場は、まさに巨人が鎬を削る戦場だ。
世界最大のファウンドリであるTSMCは、従来の「CoWoS (Chip on Wafer on Substrate)」に代わる次世代技術として「CoPoS (Chip on Panel on Substrate)」への移行を計画していると報じられている。 これは、まさにパネルレベルパッケージングへの転換を意味しており、当初は310×310mm程度のパネルサイズから着手すると噂されている。
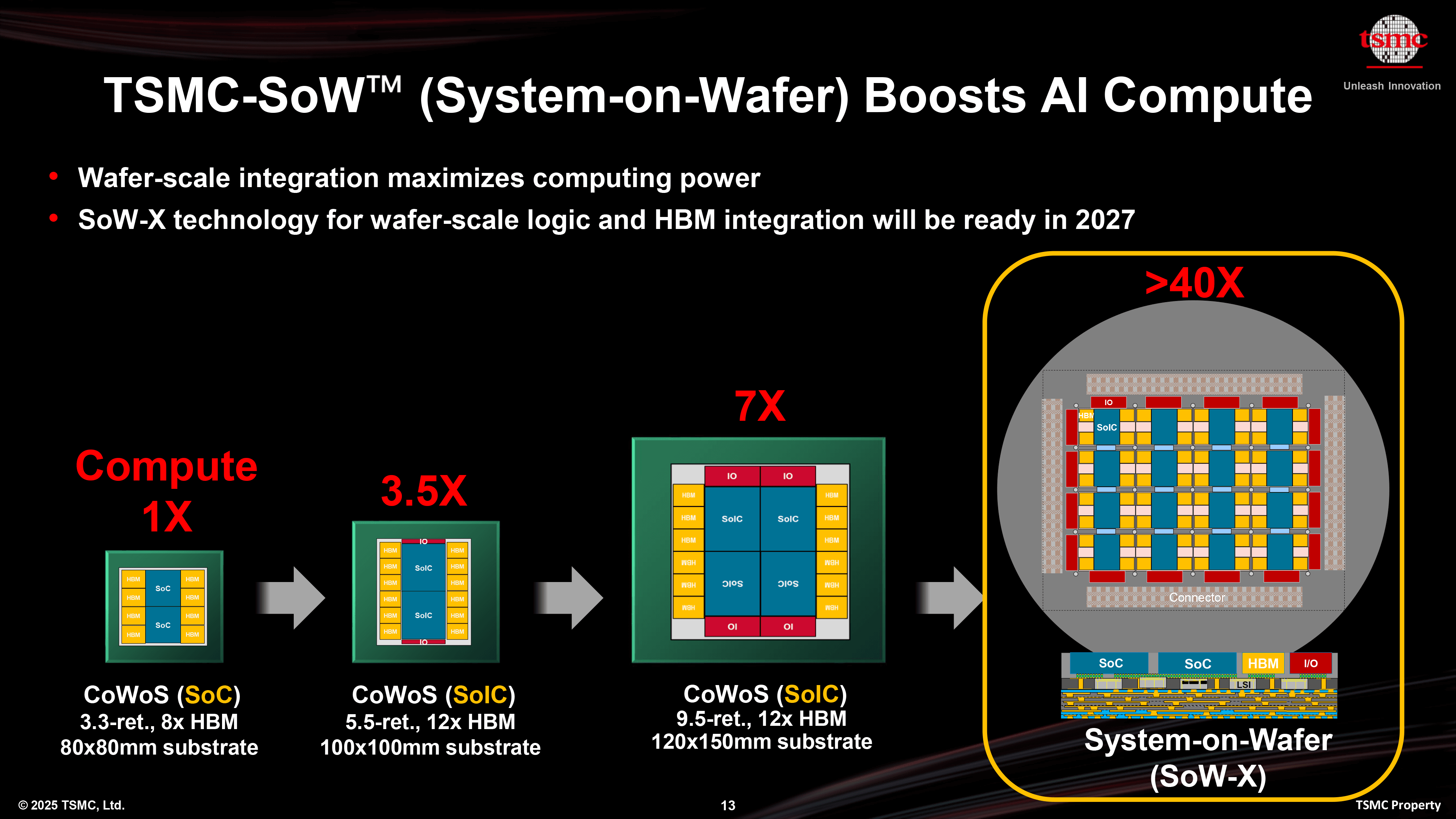
IntelやSamsungもまた、従来の樹脂やシリコンのインターポーザーに代わる「ガラス基板」への投資を加速させている。 ガラスは、平坦性や熱・電気特性に優れ、より微細な配線を形成できるため、次世代パッケージングの鍵を握る材料と目されている。
こうした業界全体の大きなうねりの中で、ニコンのDSP-100は、TSMC、Intel、Samsungといった巨大プレイヤーにとって、自社のロードマップを実現するための重要な製造装置サプライヤー候補として浮上することになる。特に、すでに業界で標準化の動きがある510×515mmのパネルサイズに対応しつつ、さらにその先の600×600mmまで見据えている点は、ニコンの先進性を示していると言えるだろう。 2026年度中の上市を予定しており、各社が次世代ラインの構築を本格化させるタイミングとも合致する。
後工程から半導体進化を再定義する一石
ニコンによるDSP-100の発表は、半導体の性能向上が「前工程」の微細化だけでは立ち行かなくなった時代において、「後工程」の技術革新こそが業界全体のブレークスルーを生むというパラダイムシフトを象徴する出来事である。
DSP-100がもたらす9倍の生産性は、これまで一部のハイエンド製品に限定されていた高性能な大型パッケージを、より広範なAIアプリケーションへと普及させる起爆剤となりうる。マスクレス技術は、多様化するチップレットの組み合わせに迅速に対応し、イノベーションのサイクルを加速させるだろう。
日本の製造装置メーカーが、光学技術と精密制御技術という自らの強みを武器に、半導体産業の最もホットな領域で再び強烈な存在感を示した。DSP-100が投じたこの一石は、静かに、しかし確実に、AI時代の半導体開発のルールそのものを変えていくに違いない。
Sources
