
Google、次世代Tensor G5はTSMCの3nmプロセスとInFO-POPパッケージングを採用する
Googleが次世代スマートフォン用チップセット「Tensor G5」の開発を加速させている。最新の報道によると、GoogleはTensor G5の製造をTSMCに委託し、同社の最先端3nmプロセスを採用する方針を固めた […]
Enter で検索 · Esc で閉じる
AD

Googleが次世代スマートフォン用チップセット「Tensor G5」の開発を加速させている。最新の報道によると、GoogleはTensor G5の製造をTSMCに委託し、同社の最先端3nmプロセスを採用する方針を固めた […]

世界最大の半導体ファウンドリであるTSMCが、最先端の3nmと5nmプロセスの価格を最大8%引き上げる計画であることが明らかになった。この値上げは、高い需要と市場での優位な立場を背景に、TSMCが利益率を維持しつつ、増加 […]

NVIDIAのCEO、Jensen Huang氏がTSMCに専用のチップパッケージング製造ラインの設置を要請したものの、断られたことが台湾メディアによって伝えられている。半導体業界で重要性を増すパッケージング技術をめぐり […]
シリコンウェハーと言えば、円形で虹色に輝くディスクのようなイメージが一般的だが、マルチチップレットプロセッサが増えていき、ますます多くのトランジスタを収容することでプロセッサの肥大化が進むことに対応する為、TSMCでは長 […]

TSMCの先端プロセスは、SamsungやIntelと言った他ファウンドリと比較して旺盛な需要により、生産能力はフル稼働状態にあるが、こうした需要の高い先端プロセスについて、同社は海外展開と電力価格の上昇によるコスト圧力 […]

SamsungはAI特需に湧く業界の中で、HBM(高帯域幅メモリ)の供給では後れを取っているが、早くも次世代のHBM4での革新に目を向けており、そこでは革新的な3Dパッケージングテクノロジーを導入する計画のようだ。 3D […]
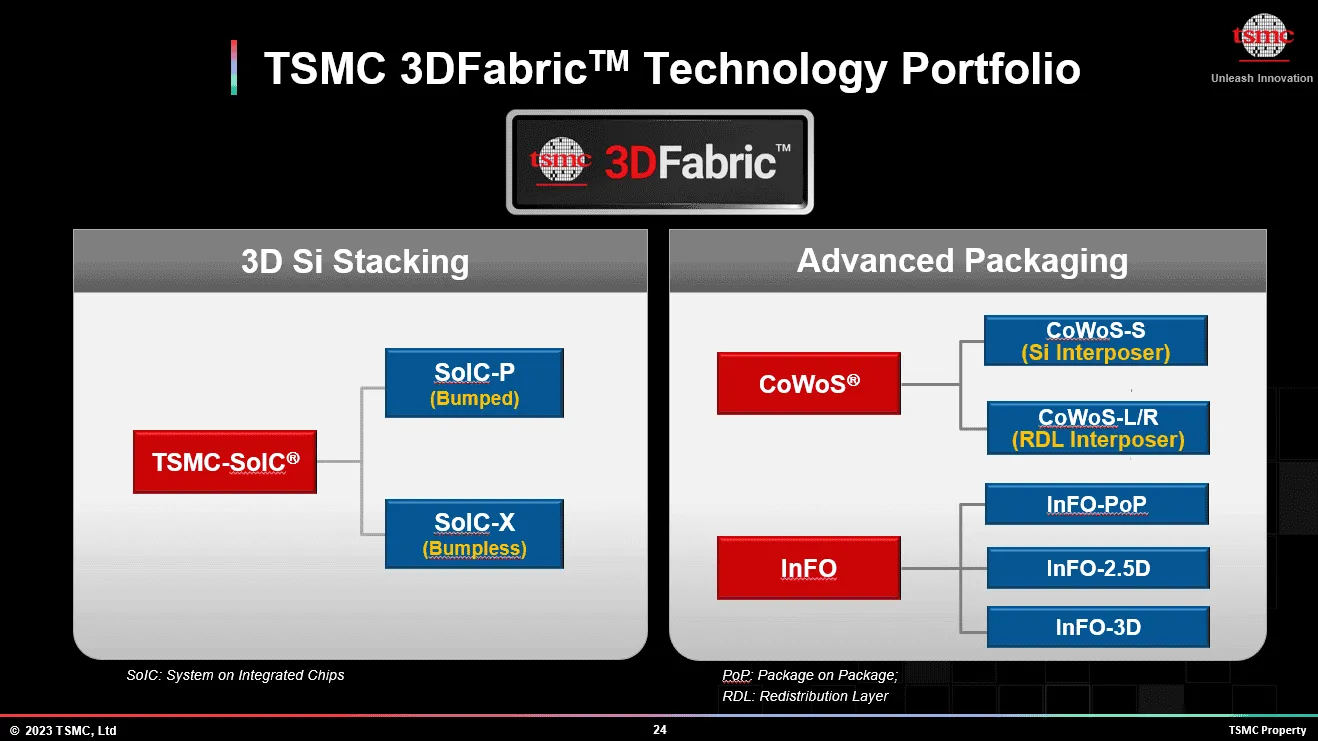
TSMCは現在全世界でテクノロジーシンポジウムを開催中だ(6月28日には日本でも開催される)。2nmや1nm世代と言った、最先端プロセスが注目されがちではあるが、同社はInFO、CoWoS、TSMC-SoIC等の先進パッ […]
TSMCは北米技術シンポジウムで、同社の今後の半導体技術とチップパッケージング技術の両方の取り組みについて詳述している。 TSMCがリリースする予定の、BSPDNを採用するA16製造ノードについてはすでに取り上げた。同社 […]
Samsungは、世界最大のメモリチップメーカーとして、来年に先進的な三次元(3D)チップパッケージング技術を発表する予定だ。この技術は、台湾のTSMCのパッケージング技術「CoWoS」と競合するもので、「SAINT(S […]
AD