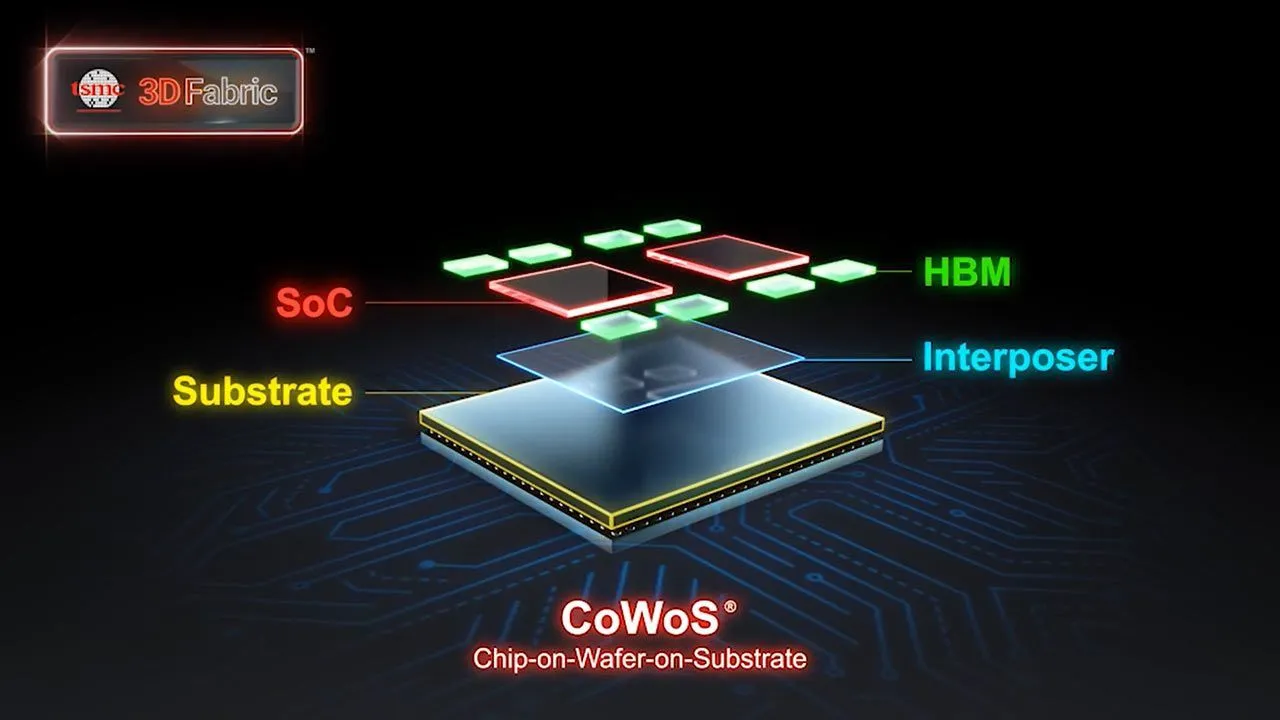
TSMC CoWoSがAI覇権を握る鍵、NVIDIAは6割独占との予測も:米国戦略拠点化で半導体地図は塗り替わるのか?
AI半導体を巡る世界の戦場は、シリコンウェハーの上から、その「後」へと静かに移行している。チップ単体の性能を競う時代は終わりを告げ、それら無数の頭脳をいかに効率よく結びつけ、真の力を引き出すかが新たな競争軸となっている。 […]
Enter で検索 · Esc で閉じる
AD
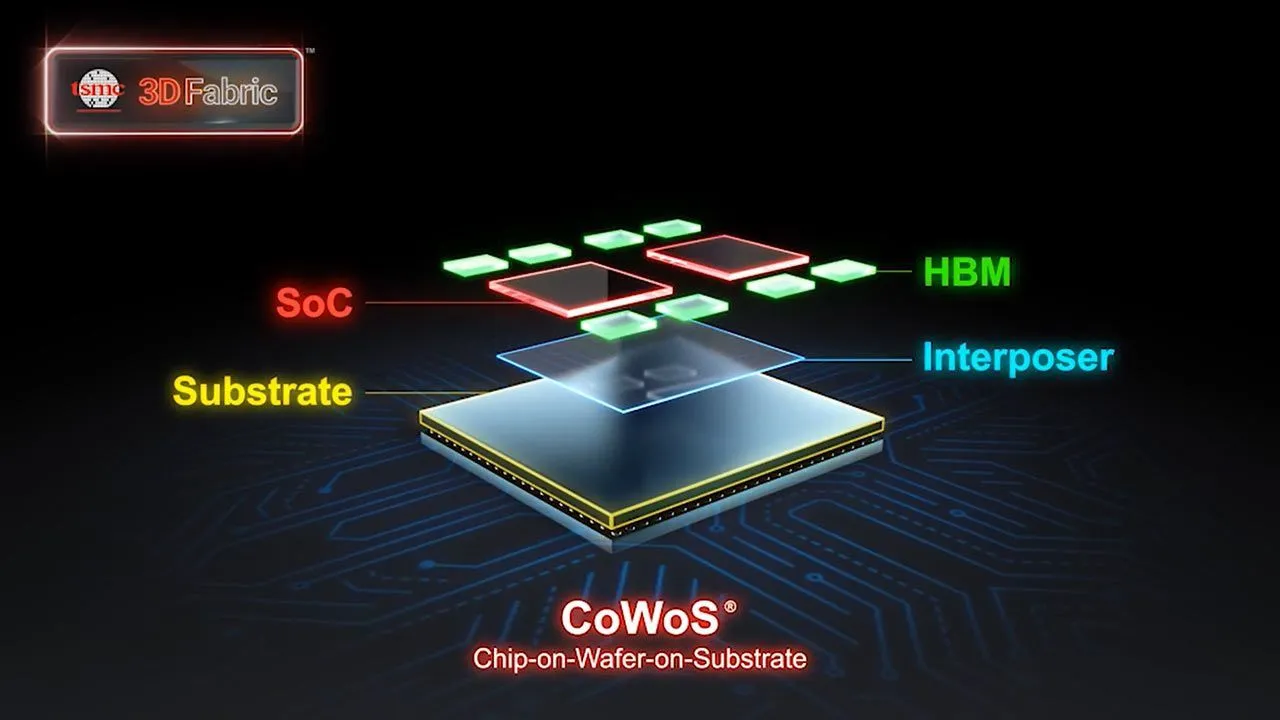
AI半導体を巡る世界の戦場は、シリコンウェハーの上から、その「後」へと静かに移行している。チップ単体の性能を競う時代は終わりを告げ、それら無数の頭脳をいかに効率よく結びつけ、真の力を引き出すかが新たな競争軸となっている。 […]

長年、Samsungの自社製SoC(System-on-a-Chip)「Exynos」に付きまとってきた「発熱」という名の亡霊。その呪縛を断ち切るべく、Samsungが次世代の切り札を準備していることが明らかになった。韓 […]

生成AIの爆発的な進化が、半導体業界の勢力図に大きな変化をもたらしている。ムーアの法則の物理的限界が囁かれる中、チップの性能向上を牽引する主戦場は、微細化一辺倒だった「前工程」から、チップをいかに賢く、効率的に繋ぐかとい […]

半導体業界の地政学的な地図を塗り替える、まさに「最後のピース」がはめ込まれようとしている。世界最大の半導体ファウンドリであるTSMCが、米国アリゾナ州に最先端のパッケージング施設を建設する計画が明らかになった。2028年 […]

世界最大の半導体ファウンドリであるTSMC(台湾積体電路製造)が、窒化ガリウム(GaN)ウェハーファウンドリ事業から段階的に撤退し、その生産拠点である新竹Fab 5を先進パッケージング用途に転用する計画を明らかにした。こ […]
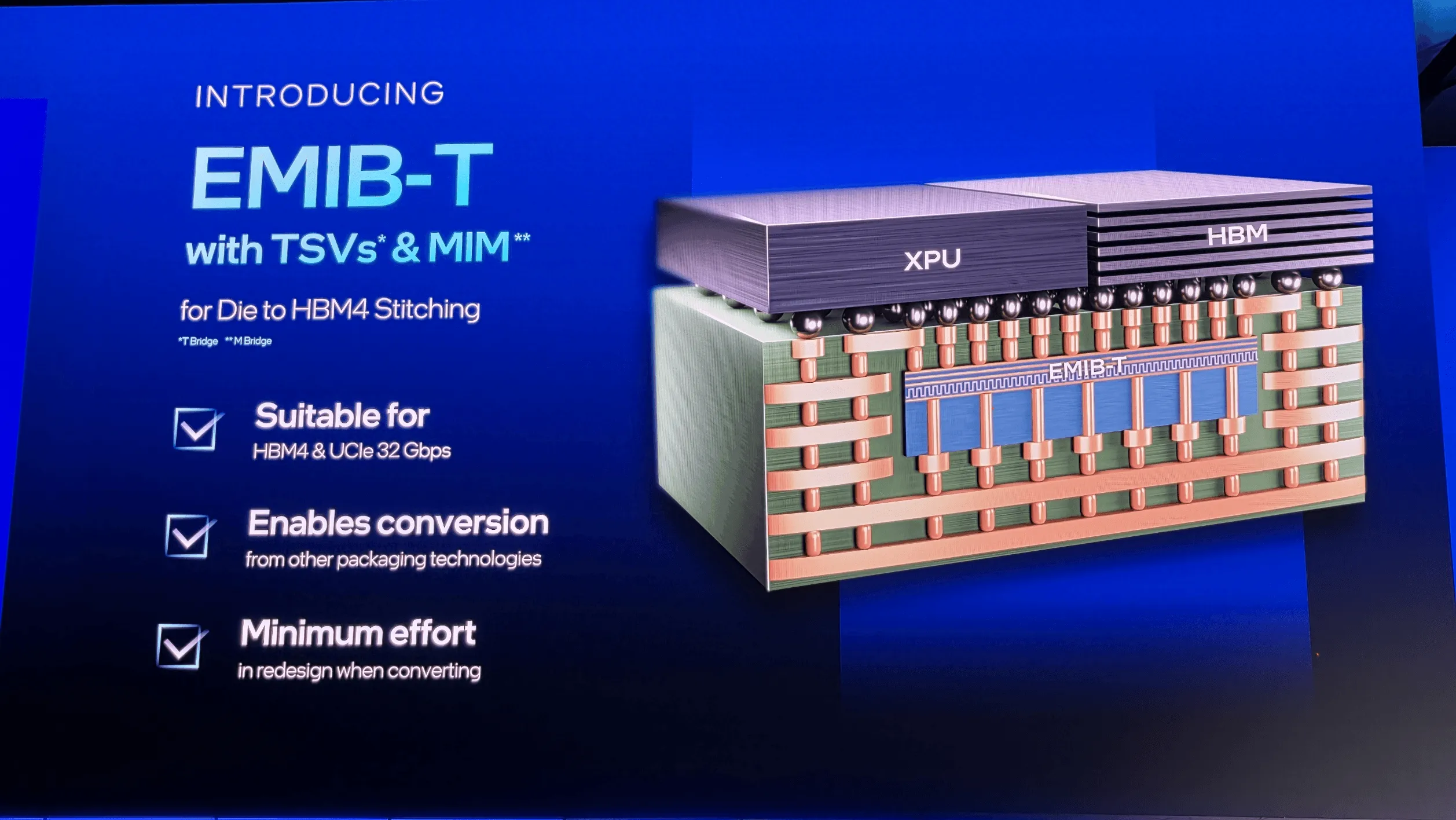
Intelは、電子部品技術会議(ECTC)において、その先進的なチップパッケージング技術であるEMIB(Embedded Multi-die Interconnect Bridge)の重要なアップグレード版「EMIB-T […]
生成AIブームが世界を席巻する中、その頭脳となるAI半導体の需要は爆発的な伸びを見せている。このAI半導体の性能を最大限に引き出す鍵となるのが「先端パッケージング技術」であり、その中でも台湾TSMCが供給する「CoWoS […]

TSMCは最新の技術シンポジウムで、AI時代の爆発的な性能要求に応えるため、チップパッケージング技術の野心的なロードマップを発表した。現行のCoWoS技術を大幅に拡張し、さらにウェハーレベルでチップを集積するSoW (S […]

NVIDIA CEOのJensen Huang氏は、同社の次世代AIチップ「Blackwell」の生産に向けて、TSMCの最新パッケージング技術であるCoWoS-L(Chip-on-Wafer-on-Substrate […]
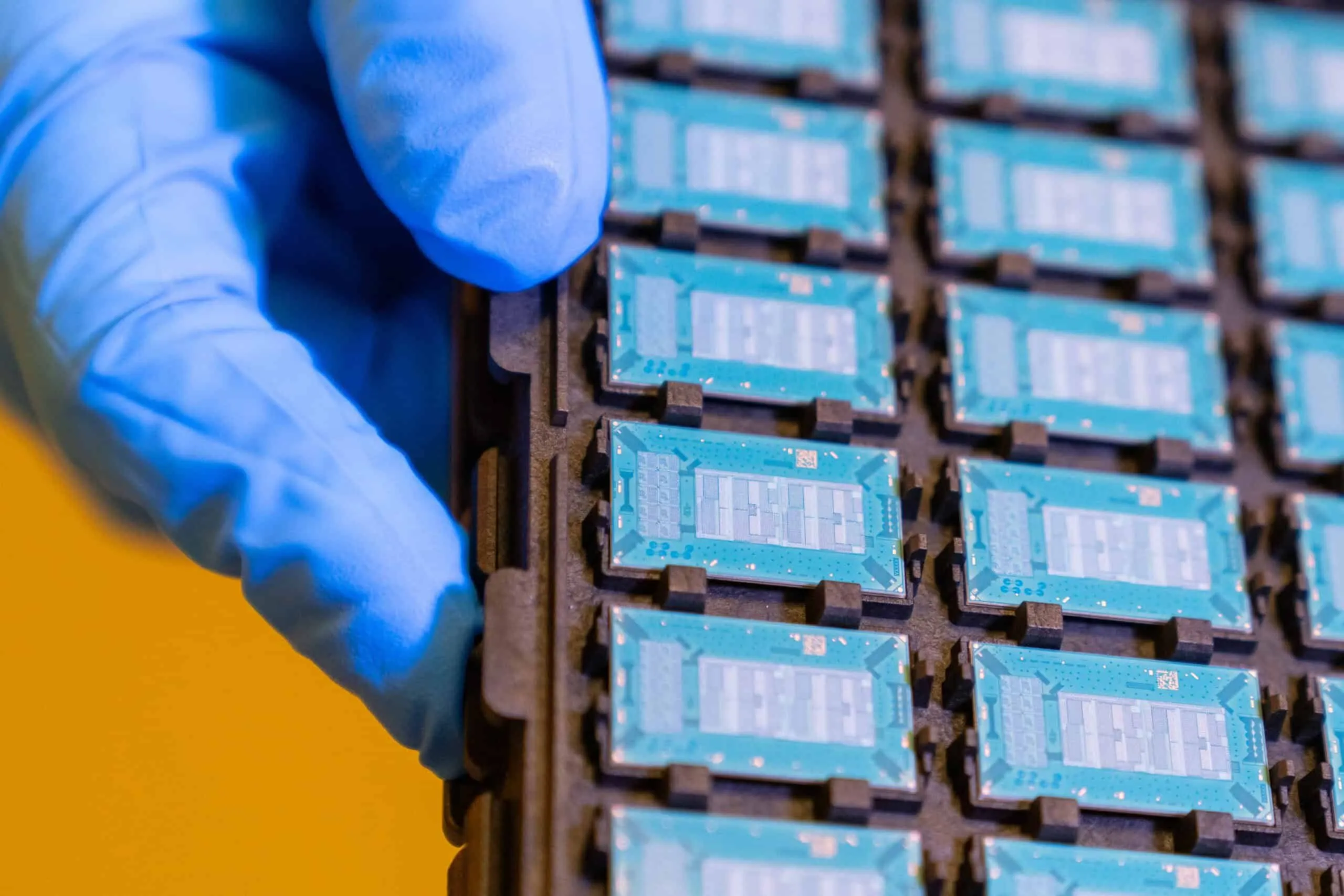
半導体大手のAMDが、次世代半導体製造の要となるガラス基板に関する重要特許(特許番号:12080632)を取得した。この特許は、将来のマルチチップレットプロセッサー向けに従来の有機基板に代わるガラス基板技術をカバーしてお […]
台湾のTSMCと米国の半導体企業Amkor Technologyが、米国での先進的なチップパッケージング技術の提供に向けて提携することを発表した。この提携は、米国の半導体サプライチェーンを強化し、世界市場での地位を向上さ […]

TSMCが2027年までに革新的なCoW-SoW(System-on-Wafer)パッケージング技術の量産を計画していることが明らかになった。この技術は、巨大なチップの開発を可能にし、これまで以上に高性能なAIチップの登 […]
AD